
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.
С быстрым развитием электронных устройств в сторону миниатюризации, многофункциональности, высокого энергопотребления и повышенной надежности появилась технология трехмерной интеграции высокой плотности для микроэлектронных устройств. Однако развитие интеграции высокой плотности сдерживается повышенными температурами перехода, вызванными тепловой концентрацией внутри чипов, что значительно снижает производительность и надежность устройств.
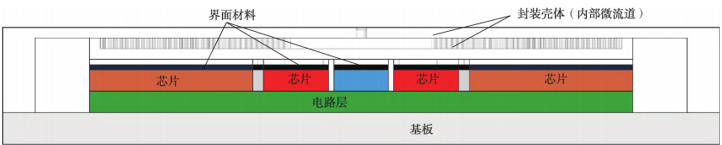
Интегрированные чипы имеют многослойную структуру, состоящую из слоев подложки, слоев микросхемы, микросхем и холодных пластин корпуса корпуса. Холодная пластина корпуса корпуса включает в себя микроканалы, которые рассеивают тепло от микросхем слоя схемы за счет конвективной теплопередачи жидкости, обеспечивая при этом равномерное распределение температуры чипа. Гибкие термоинтерфейсные материалы (TIM) соединяют холодную пластину корпуса корпуса и слой схемы.
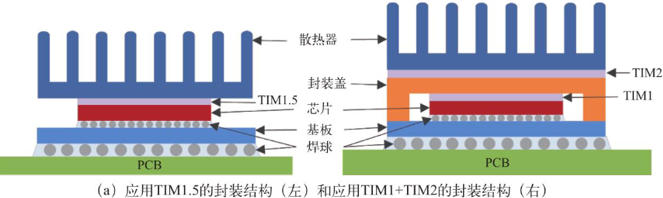
Материалы термоинтерфейса (TIM) являются важнейшими компонентами рассеивания тепла, которые заполняют микроскопические зазоры между поверхностями, напрямую улучшая тепловые характеристики. TIM обычно устанавливаются между чипом и крышкой корпуса (TIM1), чипом и радиатором (TIM1.5), а также крышкой корпуса и радиатором (TIM2). Высокая теплопроводность и надежность TIM обеспечивают быструю передачу тепла через интерфейсы. Преобладающий подход к управлению температурным режимом для высокопроизводительных чипов по-прежнему основан на материалах TIM1 со сверхнизким термическим сопротивлением, позволяющих быстро отводить тепло от внутренней части чипа к корпусу корпуса. Затем тепло передается через материалы TIM2 на пластину жидкостного охлаждения, которая быстро рассеивает его во внешнюю среду за счет быстрого потока внутренней охлаждающей жидкости.

Письмо этому поставщику

Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.

Fill in more information so that we can get in touch with you faster
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.